
КАТЕГОРИИ:
Архитектура-(3434)Астрономия-(809)Биология-(7483)Биотехнологии-(1457)Военное дело-(14632)Высокие технологии-(1363)География-(913)Геология-(1438)Государство-(451)Демография-(1065)Дом-(47672)Журналистика и СМИ-(912)Изобретательство-(14524)Иностранные языки-(4268)Информатика-(17799)Искусство-(1338)История-(13644)Компьютеры-(11121)Косметика-(55)Кулинария-(373)Культура-(8427)Лингвистика-(374)Литература-(1642)Маркетинг-(23702)Математика-(16968)Машиностроение-(1700)Медицина-(12668)Менеджмент-(24684)Механика-(15423)Науковедение-(506)Образование-(11852)Охрана труда-(3308)Педагогика-(5571)Полиграфия-(1312)Политика-(7869)Право-(5454)Приборостроение-(1369)Программирование-(2801)Производство-(97182)Промышленность-(8706)Психология-(18388)Религия-(3217)Связь-(10668)Сельское хозяйство-(299)Социология-(6455)Спорт-(42831)Строительство-(4793)Торговля-(5050)Транспорт-(2929)Туризм-(1568)Физика-(3942)Философия-(17015)Финансы-(26596)Химия-(22929)Экология-(12095)Экономика-(9961)Электроника-(8441)Электротехника-(4623)Энергетика-(12629)Юриспруденция-(1492)Ядерная техника-(1748)
Причина появления и преимущества технологии изготовления эпитаксиальных пленок
|
|
|
|
Эпитаксия

Введение
- Причина появления и преимущества технологии изготовления эпитаксиальных пленок
Эпитаксия из газовой фазы
- Идея метода, схема реактора
- Процессы массопереноса
- Химическая кинетика
- Механизмы наращивания эпитаксиальных пленок
- Легирование и автолегирование при эпитаксии
- Технологическое оборудование
- Выбор оптимальной технологии
- Дефекты эпитаксиальных пленок
Молекулярно-лучевая эпитаксия
- Преимущества метода
- Описание процесса МЛЭ
- Особенности легирования при МЛЭ
- Перспективы развития. Приборы, получаемые с использованием МЛЭ
Дополнительные вопросы
- Технология "Кремний на изоляторе"
- Оценка параметров эпитаксиальных структур
Введение
Эпитаксия - процесс выращивания тонких монокристаллических слоев на монокристаллических подложках. Существует 2 вида эпитаксии:
- гомоэпитаксия (автоэпитаксия). Процесс называют автоэпитаксиальным или гомоэпитаксиальным, если материал слоя и подложки идентичен, например, кремний выращивают на кремнии.
- гетероэпитаксия. Процесс называют гетероэпитаксиальным, если материал слоя и подложки отличается (например, AlxGa1-x выращивается на GaAs).
Наращивание имеет следующие характерные особенности:
- процесс можно производить при температуре, меньшей температуры выращивания слитка монокристалла;
- концентрация примесей и их распределение варьируются в широком диапазоне;
- возможно получение эпитаксиального слоя с противоположным типом проводимости;
- получаемый эпитаксиальный слой содержит меньше дефектов, связанных с примесью кислорода и углерода по сравнению с подложкой;
- имеется возможность нанесения однородного по толщине тонкого эпитаксиального слоя на подложку большой площади;
- эпитаксиальный слой может быть локально нанесен на определенном участке поверхности подложки.
Причиной появления эпитаксиальной технологии послужила необходимость совершенствования процесса изготовления биполярных транзисторов. Эти приборы обычно формируются в объеме полупроводниковой подложки с большим удельным сопротивлением r, определяющим высокое напряжение пробоя база - коллектор Uбк.
|
|
|
С другой стороны, высокие значения r приводят к увеличению рассеиваемой в полупроводниковой подложке мощности и уменьшению коэффициента усиления транзистора на высоких частотах. С целью разрешения этого противоречия была разработана технология получения высокоомных полупроводниковых слоев на низкоомной подложке.
 В настоящее время при изготовлении интегральных схем используются низкоомные эпитаксиальные слои с противоположным относительно подложки типом проводимости (см. рис. 1). Образующийся при этом p-n переход служит для электрической изоляции соседних транзисторов, а сильнолегированный n+ диффузионный слой используется в качестве коллекторного контакта.
В настоящее время при изготовлении интегральных схем используются низкоомные эпитаксиальные слои с противоположным относительно подложки типом проводимости (см. рис. 1). Образующийся при этом p-n переход служит для электрической изоляции соседних транзисторов, а сильнолегированный n+ диффузионный слой используется в качестве коллекторного контакта.
Ступенька, показанная на рисунке, применяется в дальнейшем при операциях самосовмещения в процессах литографии.
Слои, синтезированные по эпитаксиальной технологии, обладают следующими преимуществами:
- широкая область изменения уровня и профиля легирования;
- изменение типа проводимости выращиваемых эпитаксиальных пленок;
- физические свойства эпитаксиального слоя отличаются от свойств материала подложки в лучшую сторону, например, в них меньше концентрация кислорода и углерода, меньше число дефектов;
- процесс может происходить при температурах меньших, чем температура наращивания слитка монокристалла;
- можно нанести эпитаксиальный слой на подложку большой площади;
- эпитаксиальный слой может быть нанесен локально.
Эпитаксия из газовой фазы
|
|
|
Эпитаксия из газовой фазы.
Идея метода, схема реактора.
Термин "эпитаксия" применяют к процессам выращивания тонких монокристаллических слоев на монокристаллических подложках. Материал подложки в этом процессе выполняет роль затравочного кристалла.
Если материалы получаемого слоя и подложки идентичны, например, кремний выращивают на кремнии, то процесс называют автоэпитаксиальным или гомоэпитаксиальным. Если же материалы слоя и подложки различаются (хотя их кристаллическая структура должна быть сходной для обеспечения роста монокристаллического слоя), то процесс называют гетероэпитаксиальным.
Эпитаксиальное выращивание кремния из парогазовой фазы обычно проводят в реакторе, изготовленном из стеклообразного кварца, на помещенном внутри него пьедестале (подложкодержателе). Пьедестал служит для установки подложек и их нагрева во время процесса. Выращивание кремния проводится в потоке парогазовой смеси при высоких температурах (см. рис. 1).
Для выращивания эпитаксиального кремния используется один из четырех кремнесодержащих реагентов (тетрахлорид кремния - SiCl4, трихлорсилан - SiHCl3, дихлорсилан - SiH2Cl2 и силан - SiH4) и водород. При таких условиях возможно протекание химических реакций типа SiCl4 + 2H2 = Siтв + 4HCl.
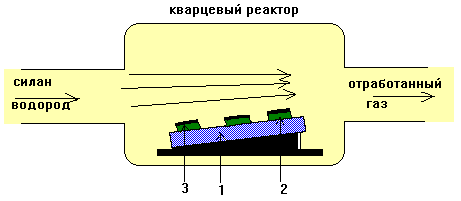
Рис. 1. Схема реактора для эпитаксии из парогазовой смеси.
1- держатель; 2- кремниевая пластина; 3- пленка.
Газ разлагается на поверхности пластины и на нее осаждаются атомы кремния. Разложение кремнесодержащих компонент происходит пиролитически, т.е. только за счет тепла. Скорость роста пленки пропорциональна парциальному давлению силана. Все вещества, поступающие в реактор являются газами, отсюда и название "химическое осаждение из газовой фазы".
Формирование эпитаксиальных пленок осуществляется при ламинарном течении газа по трубе, т. е. когда число Рейнольдса Re = D·v·r/h = 100 меньше критического значения Reкрит = 2000, где D - диаметр трубы реактора, v - скорость течения газа, r - плотность газа, h - коэффициент вязкости газа.
|
|
|
|
|
Дата добавления: 2014-12-27; Просмотров: 2058; Нарушение авторских прав?; Мы поможем в написании вашей работы!